Oxford Oxide/Nitride ICP PECVD
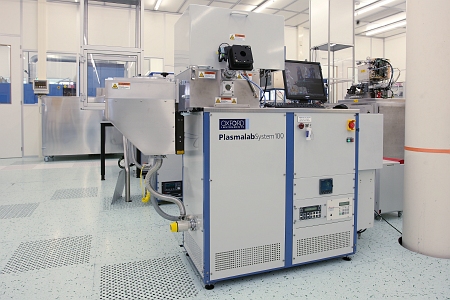
PE-CVD reactor in which the plasma is generated by an ICP-source. The system is equipped with a loadlock. | |
Name | Oxford PlasmaLab System100 ICP PECVD |
Application | Deposition of SiNx and SiOx Deposition of etching mask layers |
Characteristics | ICP-source SiH4/NH3/N2 for nitride, SiH4/N2O/N2 for oxide Optional monitoring available with in-situ spectroscopic ellipsometry |
Specimen | Wafer(like) substrates with a maximum diameter of 200 mm |
User conditions | Only used by operator |
Remarks |
|